



从研究开发到工艺生产使用,从表面微细加工到表面处理改质,等离子设备有着非常广泛的社会应用需求。
等离子设备在半导体、电子材料干式清洗中的应用越来越广泛,如硅晶片的光刻胶剥离、除去有机膜、界面活性化、微细研磨、除去碳化膜等领域,YAMATO科学的等离子产品都发挥了积极作用。

YAMATO科学的等离子表面处理设备除了半导体相关的清洗用途外,在其他各种领域都有广泛应用。
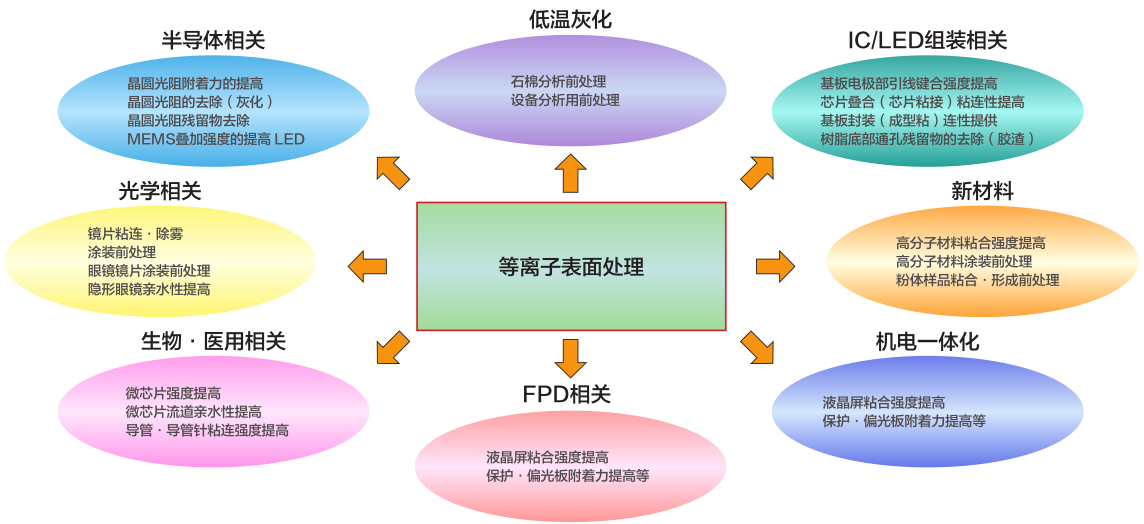
等离子处理对其他各种粘接,涂层,镀膜等强度提高都有显著效果。
DP模式圆柱型 PR/PB系列
晶圆光刻胶的剥离、使用氧气或氩气进行有机膜的去除、表面活性化、微研磨或碳膜去除等广泛领域中使用。

RIE DP方式平行平板型 PDC/V系列
RIE/DP 2种模式的等离子处理,可以使用于硅晶圆的蚀刻、干洗、以及传感器等各种COB表面活性化处理,提高导线焊接的稳定性,金属氧化物、金属氢氧化物的蚀刻及去除电极表面的接合阻碍物。
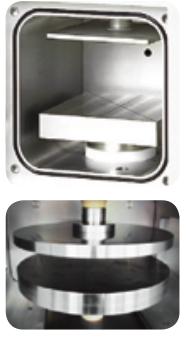
圆柱型构造(DP)
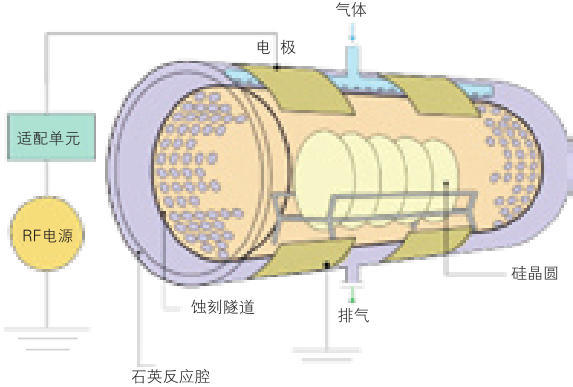
控制面板
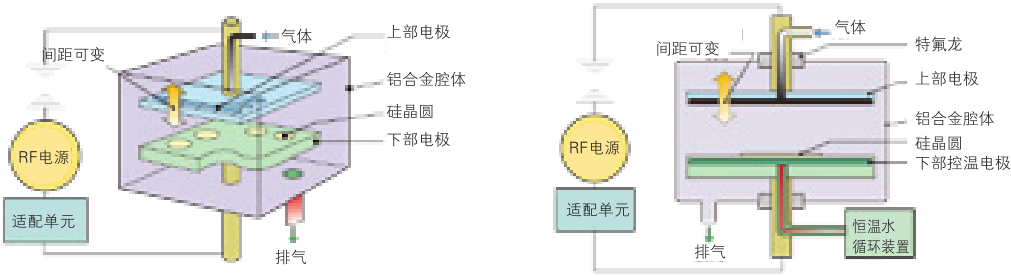
PLASMA SUPER CLEANER
IC封装技术

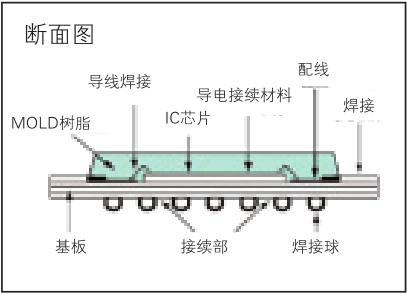
BGA(all Grid Array Package)
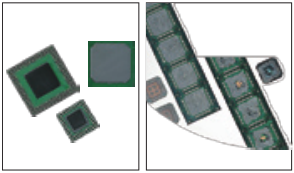
BGA型 LSI
BGA封装的等离子清洗效果
等离子装置的刻蚀及灰化方式
蚀刻
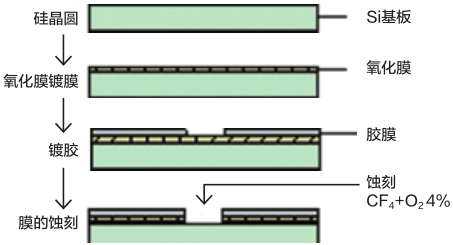
灰化
胶膜的灰化 
等离子装置的刻蚀及灰化方式
IC封装由陶瓷变为铸型树脂,导线从Ni、Ai变更为Cu。对于这些产品进步确实可以对应的等离子蚀刻·清洗技术。
Ar等离子去除金属氧化物(PDC/V/ISP系列)
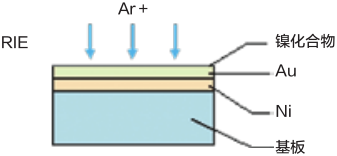
基板的清洗(V系列/ISP型)

等离子蚀刻及灰化方式
有机膜去除
成型品离形剂
锡焊残渣
油·润滑脂(薄膜)
有机膜(播磨)
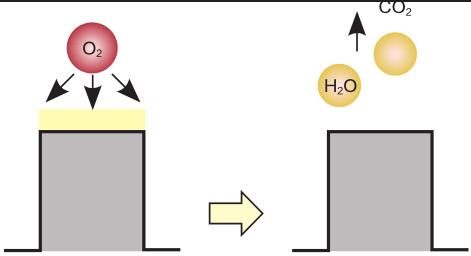
表面改质
聚酯
聚丙烯
特氟龙
陶瓷
聚酰亚胺
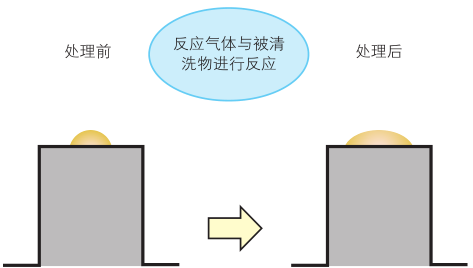
表面清洗
材料表面
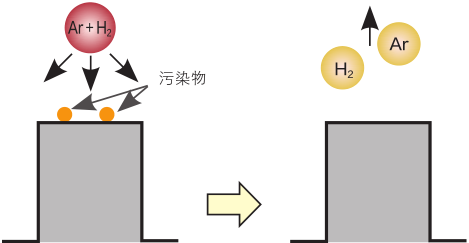
表面蚀刻
玻璃环氧树脂
聚酰亚胺
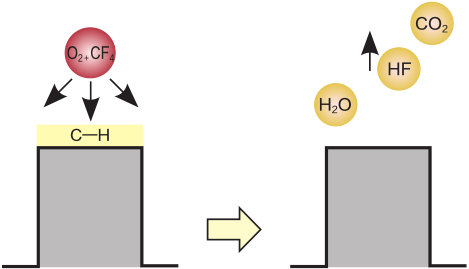
金属氧化物去除
Cu 2 O,CuO
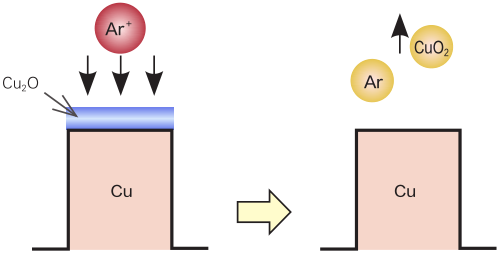
干法刻蚀
桶型
DP
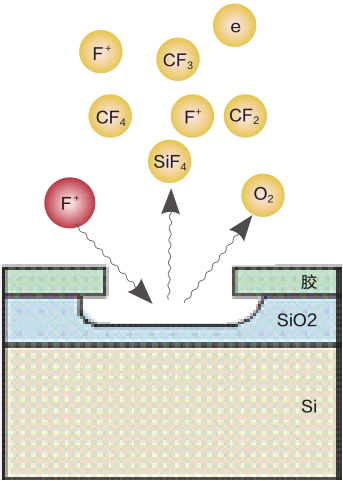
化学蚀刻(各向同性)
平行平板
飞溅
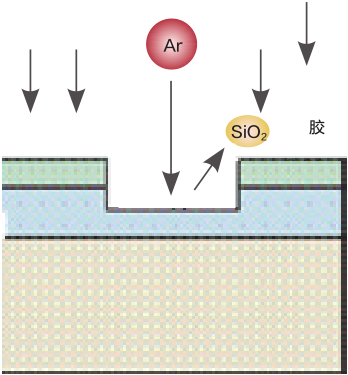
物理蚀刻(各向异性)
测定数〔例〕
测定位置
硅晶片 8inch

平行平板电极 实验1
试料胶:硅晶片 8inch
胶:正片型
电极
平行平板电极 作业面Φ350 电极间距离60mm
RF功率
500W
处理时间
5分
气体流量
500sccm
压力
100Pa
作业面温度
180℃
测定位置
①
②
③
④
⑤
平均值
ini(A)
40290
40540
40930
40620
40670
40610
after(A)
18350
19980
15930
16150
16690
17420
ini-after(A )
21940
20560
25000
24470
23980
23190
reta(A/min)
4388
4112
5000
4894
4796
4638
最大值
最小值
均一性
5000
4112
9.573092
平行平板电极 实验2
试料胶:硅晶片 8inch
胶:正片型
电极
平行平板电极 作业面Φ350 电极间距离60mm
RF功率
500W
处理时间
5分
气体流量
500sccm
压力
100Pa
作业面温度
160℃
测定位置
①
②
③
④
⑤
平均值
ini (A)
40450
40480
40820
40780
40560
40618
after(A)
25290
24780
24250
24640
23890
24570
ini-after(A)
15160
15700
16570
16140
16670
16048
reta(A/min)
3032
3140
3314
3228
3334
3209.6
最大值
最小值
均一性
3334
3032
4.704636